クリーンルームエア中に存在する酸性ガス 及び 塩基性ガスが、シリコンウエハやフォトマスク基板表面に付着することで、金属配線の腐食やヘイズ(曇り)を引き起こします。
とりわけ、半導体デバイスの微細化に伴い、半導体集積回路やリソグラフィ工程におけるレチクルのヘイズ(曇り)が大きな問題となり、基板表面に付着したイオン成分の評価の重要性が高くなっています。
自動回収装置を用いることで、各種基板表面上の付着イオンを、これまで以上に高感度・高精度に分析することや、鏡面、裏面における任意箇所の分析も可能になりました。
フォトマスク基板表面の付着イオンの評価事例
フォトマスク基板表面に付着したイオンを回収し、イオンクロマトグラフで分析した結果、微量の硫酸イオン(SO42-)とアンモニウムイオン(NH4+)などのイオンが検出されました。
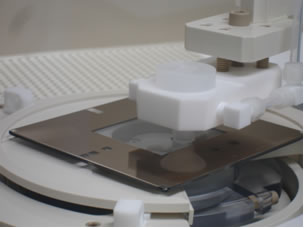
(自動回収装置 : 有限会社NAS技研社製 SC-8000)
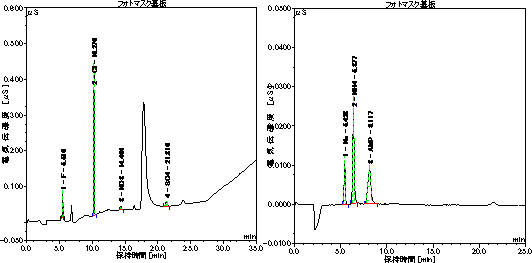
定量下限値が大幅に向上しました!
シリコンウエハの片面分析時の定量下限値を示します。
自動回収装置を用いた場合(高感度分析)の定量下限値は、これまで片面抽出用の冶具を用いて分析した場合(通常分析)の定量下限値に比べて、大幅に向上しました。
300mmφ(12インチ)ウエハの定量下限値 【×1010molecules/cm2】
| イオン | F | Cl- | NO3- | SO42- | PO43- | NH4+ |
| 通常分析 | 20 | 20 | 10 | 10 | 20 | 45 |
| 高感度分析 | 4 | 4 | 2 | 2 | 4 | 9 |
|---|
200mmφ(8インチ)ウエハの定量下限値 【×1010molecules/cm2】
| イオン | F- | Cl- | NO3- | SO42- | PO43- | NH4+ |
| 通常分析 | 30 | 40 | 20 | 20 | 40 | 100 |
| 高感度分析 | 6 | 8 | 4 | 4 | 8 | 20 |
|---|
*試料状態、回収条件、測定条件などにより、定量下限値は変わることがあります。
高い回収率でイオンを再現性良く測定できます!
フォトマスク基板表面上に各イオン成分を既知量(*)汚染させ、イオン回収とイオンクロマトグラフ測定を複数回(*)実施した時の、回収率と再現性(相対標準差:RSD)を以下に示します。
全てのイオンで、高い回収率で再現性良く測定できることが確認されています。
回収率及び再現性
| イオン | F- | Cl- | NO3- | SO42- | PO43- | NH4+ | K+ |
|---|---|---|---|---|---|---|---|
| 回収率(%) | 98.9 | 102.6 | 101.4 | 99.9 | 99.1 | 97.7 | 94.0 |
| RSD(%) | 2.7 | 4.4 | 3.7 | 2.1 | 3.1 | 1.4 | 3.7 |
*各イオン成分 100ng、試験回数 3回。
任意箇所の分析が可能になりました
基板全体(表面+裏面)、片面(表面のみ、あるいは、裏面のみ)分析に加え、片面の任意箇所の分析が可能になりました。
2-アミノ-2-メチル-1-プロパノールが存在するクリーンルーム中に曝露したシリコンウエハ(鏡面を4分割)の付着量を測定した結果を以下に示します。

任意箇所の評価結果【×1013molecules/cm2】
| 回収領域① | 回収領域② | 回収領域③ | 回収領域④ | |
|---|---|---|---|---|
| 付着量 | 4.9 | 4.8 | 5.1 | 4.9 |
酸性ガス、塩基ガスはクリーンルームエア中では気体状(ガス状)で存在し、パーティクル状で存在する金属とは異なる付着挙動を示し、基板全面に均一に付着することが確認できました。


 閉じる
閉じる