オージェ電子分光分析 (AES)とは?
スパッタを併用した測定により、構造(深さ)の情報を得ます。測定条件や前処理等の工夫により、本来の試料情報を反映したデータにすることができます。適用例(観察例)
- 電子デバイスの故障解析
- FIB加工とAES分析の複合技術
- InP表面のスパッタ荒れと組成変化の相関
- 試料回転法による多層膜深さ方向分析
- 深さ方向データ処理法
電子デバイスの故障解析
左下のSEM像のように配線に故障箇所が見られる試料について、故障箇所をねらってFIB断面加工を施し、AESによりマッピング分析を行ったところ、右下のようにアルミニウムの分布が認められました。
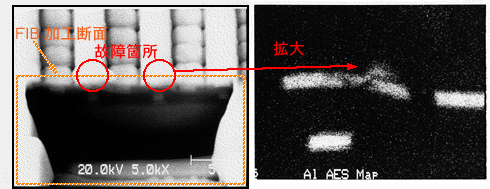
このように、見たい場所でFIB断面加工を行い、AESにより表面分析を行うことが可能です。
(注)SEM:走査型電子顕微鏡
FIB:収束イオンビーム加工
AES:オージェ電子分光分
InP表面のスパッタ荒れと組成変化の相関
InPはイオンスパッタリングにより表面荒れが生じることが一般的に知られています。 そして表面荒れと組成の変化に相関があるかどうかに興味が持たれています。 そこで、真空中でInP基板を劈開して汚染層および酸化膜を有しない表面を作製し、オージェ電子分光法を用いて、スパッタリングによる組成変化を調べました。例を以下に示します。 スパッタ速度が速いほど、組成ずれが少ないことがわかりました。実試料の測定では、このような検討結果をもとにできるだけ組成変化の少ない条件で分析を進めております。
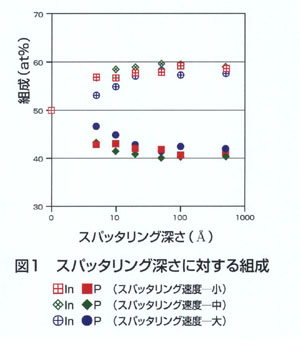
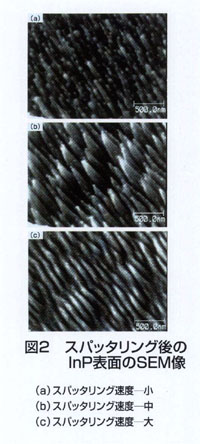
試料回転法による多層膜深さ方向分析
組成の深さ方向分布の分析には、イオンスパッタリングを併用したオージェ電子分光法が一般的に用いられますが、スパッタリングによる表面荒れ等の問題で表面から深くなると界面分解能が低下してしまいます。そこで、スパッタリング中に試料を回転させることで、イオン線に対する異方性を緩和し表面荒れを軽減して深くまで分解能高く測定することが可能となります。
Ni/C多層膜がシリコン基板上に5組スパッタ蒸着されているものを試料として、スパッタリング中に回転させた場合とさせない場合を比較しました。なお、Ni層およびC層の厚さは各々43.3nmで構成されています。

試料を回転させない場合の深さ方向分布

試料を回転させた場合の深さ方向分布
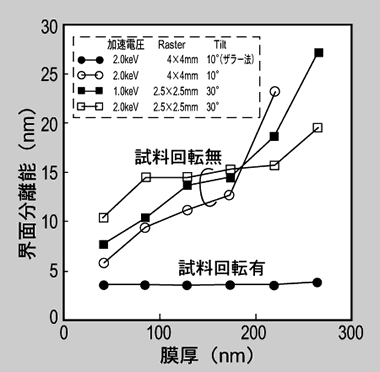
試料を回転させると、深くまで界面分解能を低下させることなく
測定できることがわかります。
深さ方向データ処理法
電子分光法を用いた深さ方向分析においては、ピークのエネルギー位置が重なる場合に実際には存在しない深さ方向プロファイルが得られることがあります。当社では、状況に応じてTFA(ターゲットファクターアナリシス法)処理やLLS(最小二乗平均法)処理を行い、重畳するピーク成分を分離し、目的元素のピーク成分を抽出することにより、より実際の分布に近いデータを提供します。
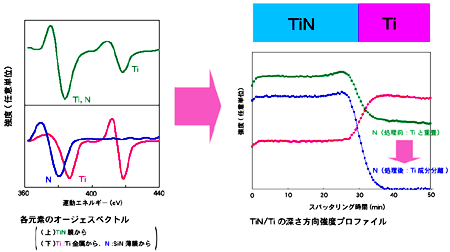
TiN層を含むオージェ深さ方向分析では、TiとNのピークの重畳により、Nの存在しない領域でもNが存在するかのように見えることがあります。この例では、380eV付近のピークからTiピーク成分をTFA法を用いて分離処理を行うことにより、Ti層でのN強度はゼロになり、実際の試料構造を反映したデータが得られることを示しています。


 閉じる
閉じる