Micro-Samplingを搭載したFIBシステムを用いれば、試料をチャンバに入る大きさにさえカットしておけば、後の作業は全てFIB装置内で出来ます。 チャンバから取り出したら即座にTEM観察可能です。
このシステムを用いることにより、今までのFIB技術が持っていた弱点
- 隣接したデバイスの観察が出来ない
- 平面観察用サンプルの作製が出来ない
- ダイシングによる破損のリスクがある
- 金属材料ではダイシングによる加工歪みの影響を避けるのが困難
を補うことが出来ます。
Micro-Sampling技術のイメージ
-
FIBで目的場所の周辺に堀を作り、基板から目的の場所を抜き取る準備をする。
-
目的の場所を含む小片をWのマイクロプローブで引き抜く。
-
TEM観察用Cリングに小片を固定する。
-
FIBでTEM観察可能な厚さまで薄片化する。
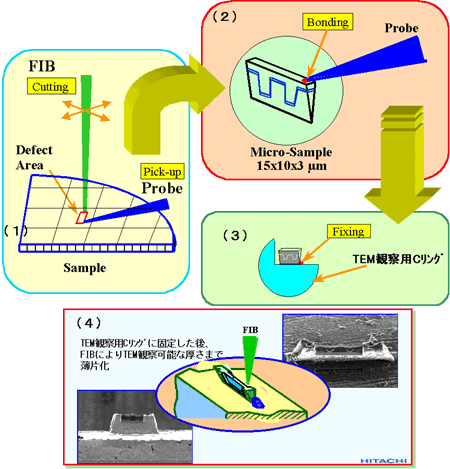
静電破壊MOSトランジスタの断面構造観察
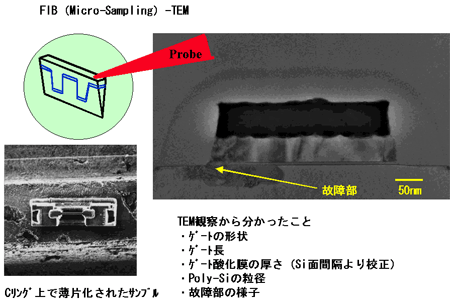


 閉じる
閉じる