二次イオン質量分析(SIMS)とは?
固体試料表面にイオンビームを照射し,スパッタリングにより生じた試料構成元素の二次イオンを検出します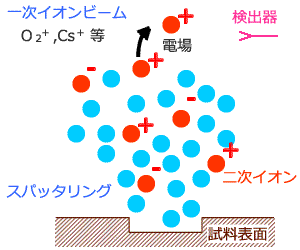
分析イメージ
一次イオンビームを低エネルギー化した二次イオン質量分析装置を導入し、半導体中の浅い領域のドーパントの分析や薄膜多層膜の分析など、フローティング銃導入により高精度な深さ方向元素分布の測定が可能になりました。
特徴
- スパッタリングによる深さ方向分析 深さ分解能:数nm〜
- 高感度&広いダイナミックレンジ 検出濃度10ppb〜1%
- 二次元&三次元分析
- 同位体分析
超格子構造のSIMS分析例
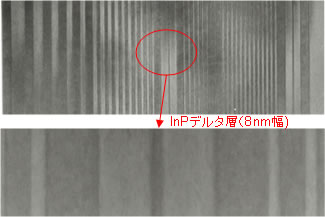
上図は化合物超格子構造の電子顕微鏡写真です。
下図は化合物超格子構造において、1μmの深さに存在するInPデルタ層(8nm幅)を高い深さ方向分解能で検出した結果を示します。
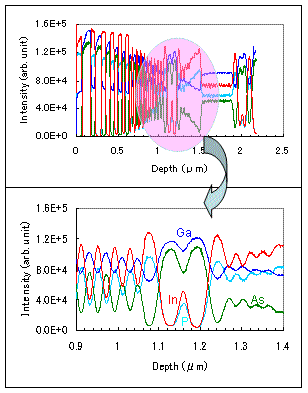
次の図は、Si中の8nmピッチのBデルタドープ層を、高精度で深さ方向分析を行った事例です。

適用例(観察例)
- GaN試料の深さ分布を正確に得るために
- 深さ分解能評価関数を用いた真の拡散分布の推定
- 鉄鋼中の二次イオン像面分析
GaN試料の深さ分布を正確に得るために 二次イオン質量分析
GaN中の不純物分布はSIMSにより日常的に評価されています。しかしながら、O2+を一次イオンとしたSIMS分析では、通常のイオン照射条件で、波状の表面粗れが生じることがあります。測定中に生じる表面粗れは、深さ方向分解能を著しく劣化させるため、正確な深さ分布を得るためには好ましくありません。NTT-ATでは、分析時に生じる表面粗れを小さくする測定条件を把握することにより、深さ分解能の高い分析データを提供しています。

上図は、GaNをO2+により10 keV, 45°の条件でスパッタした表面のAFM像です。波状の凹凸が生じているのが明瞭にわかります。
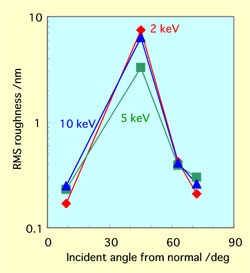
上図は、GaNを種々の条件でO2+によりスパッタした表面の粗れ(RMS)です。O2+によりGaNを測定する場合、いずれのスパッタエネルギーでも45°近傍での入射は表面粗れが大きく、深さ方向分析には適さないことがわかります。
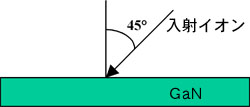
深さ分解能評価関数を用いた真の拡散分布の推定
SIMSのスパッタ深さ分析では、測定時の原子混合効果や表面粗れのため、得られた結果は、真の分布よりも広がったものとなります。そこで、この広がりの影響を深さ分解能評価関数を用いて予め見積もり、SIMS分析で得られた結果から、真の拡散分布を推定することが重要です。ここでは、深さ分解能評価関数としてMRI法を用いて、シリコン酸化膜のSiの自己拡散分布の解析例を紹介します。
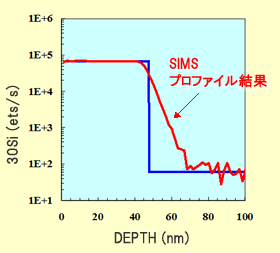
熱処理前
左図は、天然同位体組成SiO2/28SiO2(未処理)構造の30Siの深さ方向分布です。
熱処理していないため、本来30Siの分布は青線のように急峻であるべきですが、SIMSの結果は赤線のように広がったものとなります。
この分布をMRI解析することにより、深さ分解能パラメータを決定します。
熱処理していないため、本来30Siの分布は青線のように急峻であるべきですが、SIMSの結果は赤線のように広がったものとなります。
この分布をMRI解析することにより、深さ分解能パラメータを決定します。
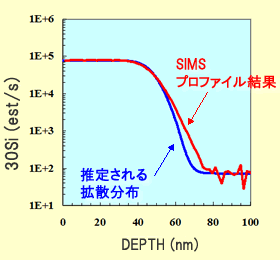
熱処理後
右図の赤線は、同構造の熱処理をした30SiのSIMSによる深さ方向プロファイルです。
熱処理前(上図)の解析により決定した深さ分解能パラメータを用いて、SIMSプロファイルを解析することにより、真の拡散分布を推定しました(青線)。
熱処理前(上図)の解析により決定した深さ分解能パラメータを用いて、SIMSプロファイルを解析することにより、真の拡散分布を推定しました(青線)。
語句の説明
| ※1 MRI | mixing-roughness-information depth |
|---|
鉄鋼中の二次イオン像面分析(RAE分析)
鉄鋼材料の高強度化に伴い、水素に起因する遅れ破壊が関心を集めています。従来、金属中の水素の存在を可視化する方法として、トリチウムオートラジオグラフィが用いられ、粒界周辺に水素がトラップされていることが確認されていますが、放射性元素を用いるので取り扱いが困難です。そこで、SIMSを用い高強度鉄鋼中の水素、重水素等の二次イオン像面分析(RAE分析)を行いました。下のイオン像から高強度鋼の遅れ破壊試験により導入されたHがPの偏析帯にトラップされている様子がわかります。(a)、(b)にP、H各々のイオン像、(c)に(b)の矢印方向にラインスキャンしたHイオン強度分布を示します。

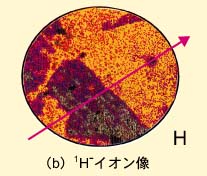



 閉じる
閉じる