
窒化物半導体エピタキシャルウェハとは?
窒化物半導体を用いたパワーデバイスは、これからの低炭素社会を支えるグリーンデバイスとして期待されています。
NTT-ATは窒化物半導体エピタキシャルウエハの製造技術により、省エネルギー化の早期実現に貢献します。
パワーデバイスの開発に、こんな課題をお持ちではありませんか?
- 使用する基板種が決まっていない、様々な基板種を試したい。
- 少量多品種での試作をしつつ、将来の量産体制も確保したい。
- 当然、大口径サイズも必要。
NTT-ATの窒化物半導体エピタキシャルウェハなら
- シリコン(Si)、サファイア(Al2O3)、シリコンカーバイト(SiC)、窒化ガリウム(GaN)基板上に結晶成長する技術を有しており、窒化物系に使われるすべての基板に対応できます。複数の基板種を用いた開発検討を併行して進められます。お客様の大切な時間を無駄にしません。
- 少量の試作から量産まで承ります。
- 大口径8インチシリコン基板にも対応しております。 また当社関連部門との連携によって、デバイス作製や材料分析も可能です。
適用例

- USB小型急速充電器
- LED街路灯
- 携帯基地局用パワーデバイス
- 車載用パワーデバイス
- 家電用パワーデバイス
- 耐環境デバイス
HEMT structure for Power application (on 6 inch Si)
即納可能製品あります。お問い合わせください。
ご希望の Part Number をクリックすると、お問い合わせフォームが表示されます。
お手数ですが、ご要望欄に 【Part Number】 と 【数量】 の記載をお願いいたします。
| Part Number | GaN cap | AlGaN Barrier | AlN | Channel | |
|---|---|---|---|---|---|
| Content | Thickness | Spacer | |||
| SEE61K22227S20G | 2nm | 0.22 | 27nm | 1nm | 200nm |
| SEE61K22227S30G | 2nm | 0.22 | 27nm | 1nm | 300nm |
| SEE61K22515S30G | 2nm | 0.25 | 15nm | 1nm | 300nm |
| SEE61K22520S30G | 2nm | 0.25 | 20nm | 1nm | 300nm |
| SEE61K22525S30G | 2nm | 0.25 | 25nm | 1nm | 300nm |
| SEE61K23020S30G | 2nm | 0.30 | 20nm | 1nm | 300nm |
| SEE61K21745N30G | 2nm | 0.17 | 45nm | - | 300nm |
| SEE61K22520N30G | 2nm | 0.25 | 20nm | - | 300nm |
| SEE61K22520N35G | 2nm | 0.25 | 20nm | - | 350nm |
| SEE61K22520N40G | 2nm | 0.25 | 20nm | - | 400nm |
| SEE61K22526N15G | 2nm | 0.25 | 26nm | - | 150nm |
| SEE61K22526N20G | 2nm | 0.25 | 26nm | - | 200nm |
| SEE61K22526N35G | 2nm | 0.25 | 26nm | - | 350nm |
| SEE61K22527N35G | 2nm | 0.25 | 27nm | - | 350nm |
| SEE61K23020N30G | 2nm | 0.30 | 20nm | - | 300nm |
| SEE61K02822S30G | - | 0.28 | 22nm | 1nm | 300nm |
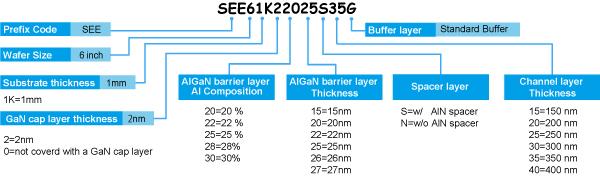

| Cap Layer | |
|---|---|
| Material | GaN |
| Thickness | 2 (nm) or No cap |
| Barrier | |
| Material | AlGaN |
| Al content | 20~30 (%) |
| Thickness | 15~ 27 (nm) |
| Channel | |
| Material | GaN |
| Thickness | 150~400 (nm) |
| Buffer | |
| Doping | C-doping |
| Thickness | ~3900 (nm) |
| Substrate | |
| Silicon | 1mm thickness |
| Features | |
|
Sheet resistance: 350~400 ohm/sq. (w/ AlN spacer), 450~500 ohm/sq. (w/o AlN spacer) Electron Mobility: ~ 1700 to 1900 cm2/Vs FWHM (002): <800 arcsec FWHM (102): <1400 arcsec Breakdown voltage: 800 V – 1000 V (depending on the device structure) Bowing value: < 50 um |
|
AlGaN/GaN HEMT構造エピ製品(一例)
| Cap Layer | Material: GaN | |||
|---|---|---|---|---|
| doped or un-doped | ||||
| Thickness: 0~5 nm | ||||
| Barrier Layer | Material: AlGaN with or without AlN spacer | |||
| doped or un-doped | ||||
| Al-content:10~50% | ||||
| Thickness: < ~50 nm | ||||
| Buffer Layer | Material: (Al)GaN | |||
| Thickness: 1~3 μm | ||||
| Substrate | Si | Sapphire | SiC | GaN |
| 2~8 inch | 2~3 inch | 2~6 inch | 2~4 inch | |
ご提供可能なラインアップ( 6 inch & 8 inch )
| on Si substrate | AlGaN/GaN HEMT structure | |
|---|---|---|
| 6 inch | 8 inch | |
| GaN cap | ✔ | ✔ |
| in-situ SiN (~5nm) | ✔ | ✔ |
| in-situ SiN (~40nm) | ✔ | ✔ |
|
p-GaN (~80nm)
(Mg: 2x1019 cm-3) |
✔ | ✔ |
資料ダウンロード
| 「InAlN/GaN HEMTエピウエハ」カタログ | 824KB | PDFダウンロード |
|---|---|---|
| 「GaN EPITAXIAL WAFERS」カタログ (英語) | 3.8MB | PDFダウンロード |
| GaNエピタキシャルウエハ 関連文献 (英語) | 218KB | PDFダウンロード |
データ資料 「デバイス製造歩留まり向上が期待されます - 優れた均一性を持つ 8インチ AlGaN/GaN エピタキシャルウェハ」
ご希望の方はお問い合わせフォームよりお申込みください。
データ資料請求ご希望の方はお問い合わせフォームよりお申込みください。
お問い合わせ
上記以外の資料請求・お問い合わせは、お問い合わせフォームより承ります。
資料請求・お問い合わせ関連サービス
「本製品や試作したデバイスについて構造分析や成分分析をしたい」というお客様には
「デバイス試作プロセスを外注したい」というお客様には
※ 本製品は、経済産業省の輸出管理令別表第一の7(18)に該当し、輸出には経済産業省の許可が必要です。
※ 本ホームページに記載の内容は、製品の改良に伴い予告なしに変更する場合があります。


 閉じる
閉じる