FIB-SEMによる3次元構造の観察例
金属材料の結晶粒界の観察例
観察対象物を最適な観察条件にて、明瞭な3D画像を取得いたします。
-スライス動画例-任意の角度・位置で評価を行うことができます
画像を取得するSEMは幅広い加速電圧で高分解能・高コントラストで観察できます。
弊社では試料へのダメージやチャージアップの影響も考慮した上で明瞭な像が得られる条件で3D画像を取得します。
材料:Cu
サイズ(xyz):5×5×5μm
加速電圧:1kV
加工ステップ:20nm
ステップ数:250回
結晶粒界が明瞭に見える条件※に調整してSEMを撮影しました。
※チャネリングコントラストが最大になる条件(加速電圧等)
取得した画像データはお客様へお渡しすることができます。そのため、お手持ちの画像ソフト等での編集が可能です。例えば、ImageJ(画像処理ソフトウェア)にて3D再構築や解析を行うことができます。
多層配線の観察例
多層配線の観察例をご紹介します。
(1)連続的な断面加工とSEM像取得

FIBですこしずつ加工し(例えば100nmステップ)、露出した断面をSEM観察します。
(2)3D再構築

取得した複数枚のSEM像をソフトウェアで3Dに再構築します。
(3)任意断面の抽出による構造解析
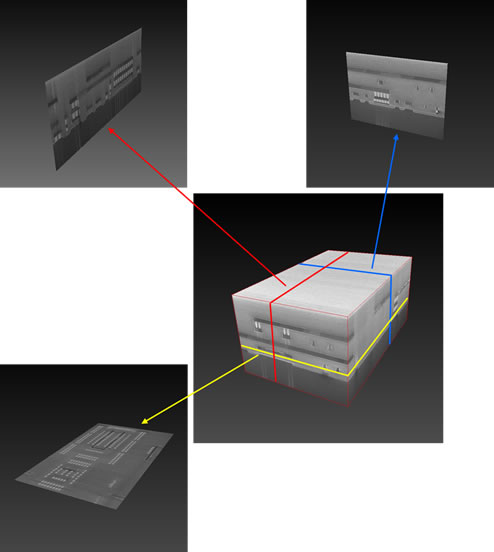
任意の断面を抽出し可視化することで、従来の方法ではできなかった様々な方向から、構造を把握することが可能となります。例えば、粒子、空孔、異物や欠陥といったものの形状や分布などを、立体的な視点から解析することが可能です。
FIB-SEMによる3D再構築とは
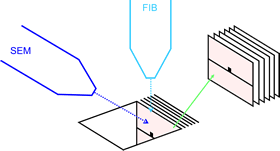
FIB-SEMの概要図
FIB-SEMとはFIB(Focused Ion Beam:集束イオンビーム)装置で試料の加工、露出した断面のSEM(scanning electron microscope;走査型電子顕微鏡)観察をします。
3D(3次元)再構築は試料の加工と観察を繰り返し、そのSEM画像をコンピュータで処理することで試料構造を立体的に観察する分析手法です。
従来のFIB-SEM観察では立体的な構造を調べるためには、加工・観察を繰り返して数多くの写真を取得し、それを並べて考察していました。
今回の3D再構築では、その写真をソフトウェアで処理し立体的な像にします。そのため、ソフトウェア上で立体画像を動かしたり、任意の方向から任意の断面を取り出すなど、様々な解析が可能かつ迅速に行えるようになります。
さらにFIBとSEMが同一装置内にあるため、露出した断面を大気に触れることなくSEM観察ができるメリットがあります。例えば"電池材料"も大気にさらされるダメージを受けずに観察が可能となります。
弊社ではNTT研究所の様々な材料の分析から得た技術・経験を有しております。次世代エネルギーの燃料電池・太陽電池の開発、さらにレアアースを使わない新素材開発など、さまざまな分野の物質材料が分析可能です。ぜひ弊社分析サービスにご相談ください。
まずはお問い合わせください。
お客様のさまざまな課題解決を、私たちの分析サービスがお手伝いします。
お気軽にお問い合わせください。


 閉じる
閉じる