概要
従来のSi(シリコン)に代わる次世代パワー半導体のSiC(炭化ケイ素)基板もSiと同様に基板表面の金属汚染がデバイス特性に大きな影響を及ぼすことから、高い清浄度が求められています。
SiC(炭化ケイ素)基板
ここではTXRF,ICP-MSの各手法を用いた次世代パワー半導体のSiC基板表面の汚染分析事例をご紹介します。
全反射蛍光X線分析(TXRF)とは
ウエハ全面の汚染元素マッピング(Sweeping-TXRF)では、ウエハ全面を高速で分析し、マッピングデータから汚染の分布と量が同時に分かります。さらに、Sweeping-TXRFの結果を元に、通常の全反射蛍光X線分析(Direct-TXRF)で高精度な分析もできます。汚染評価事例
ここでは、カルシウム(Ca)の濃度分布図を示します。測定条件
有効領域:約70mmφ(エッジカット約15mm)測定点数:計49点
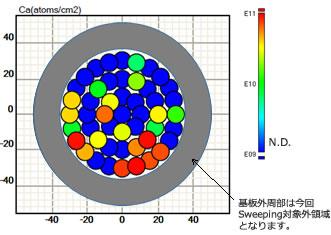
図1.Sweeping-TXRF Dot
詳細なマッピングデータから、測定したSiC基板上のカルシウム(Ca)汚染には、1010~1011atoms/cm2レベルの分布があることが明らかになりました。Sweeping-TXRFによって明らかとなった汚染箇所のカルシウム(Ca)量をDirect-TXRFで定量したところ3×1011atoms/cm2でした。 (図2)
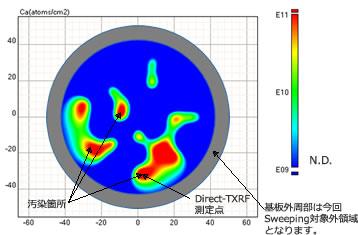
図2.Sweeping-TXRF Gradation
また、スペクトルからは、カルシウム(Ca)以外にも、複数の汚染元素が検出されていることが分かります。 (図3)
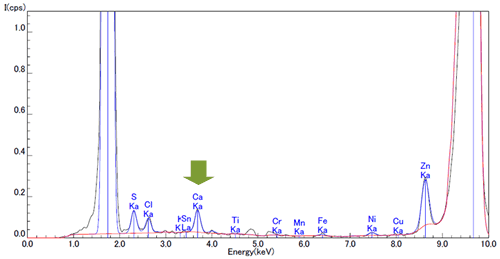 図3.Direct-TXRF Spectrum
図3.Direct-TXRF SpectrumICP質量分析(ICP-MS)とは
水溶液中の極微量金属・非金属元素の分析となります。フッ化水素酸系溶液などでSiC(炭化ケイ素)基板表面上を走査し、金属元素を回収し、その回収液をICP-MSで定量します。ICP-MSを利用したこの分析手法は、シリコンウエハと類似した手法です。
しかしながら、特定の元素においては、基板表面からの回収率が低い傾向にあるため、元素毎に回収試験を実施し、高い回収率が得られる手法を確立する必要があります。
セリウム(Ce)の回収率検討
SiC基板表面上に既知量のセリウム(Ce)元素を汚染させ、一般的なフッ化水素酸系の回収溶液にて回収した際には十分な回収率が得られず、低い回収率にとどまりました(図4)。 その後、さらにAT社独自の回収溶液で回収した際には、基板表面上からすべて回収されました(図5)。Sweeping-TXRFのマッピングデータにて基板表面を視覚化したものを以下に示します。

図4.フッ化水素酸系溶液で回収した後の
マッピングデータ
マッピングデータ

図5.AT社独自の回収溶液で回収した後の
マッピングデータ
マッピングデータ
ICP-MSにて分析対応可能な元素



 閉じる
閉じる