半導体メーカーの方へ
半導体製造プロセスに必要な清浄度の管理評価にお応えします!
迅速に、高感度に、かつ多くの元素を検出できる分析方法が必要です。

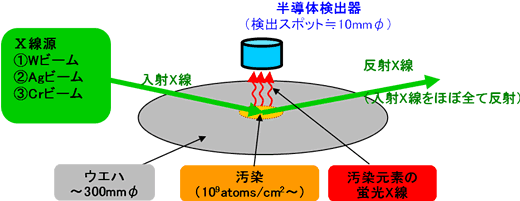
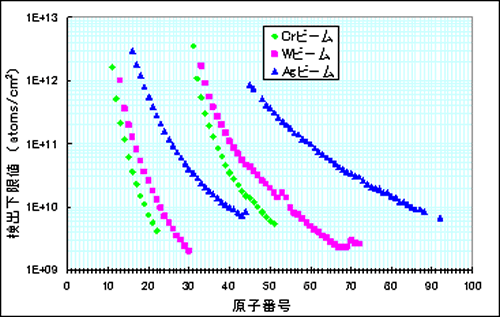
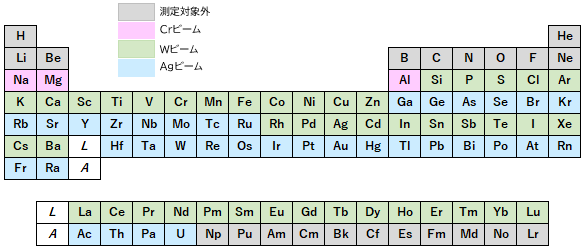
TXRF、ICP-MSにて評価した次世代パワー半導体の基板表面の極微量金属汚染事例です。
半導体製造プロセスに必要な清浄度の管理評価にお応えします!
半導体製造プロセスでの汚染を防ぐために・・・
半導体の製造において清浄度は品質を決める重要なポイントです。
製造工程における汚染を確認する必要があります。
迅速に、高感度に、かつ多くの元素を検出できる分析方法が必要です。
こんなことでお困りなら、NTT-ATの全反射蛍光X線分析を!

|
現在の分析方法で、こんなお悩みはありませんか?
|
|
NTT-ATの全反射蛍光X線分析なら ■迅速 サンプル受付後、1~2営業日での対応が可能です。 ■高感度
■多元素
■広範囲な適用サイズ
|
※検出元素に制限があります。ご相談ください。
分析の仕組み
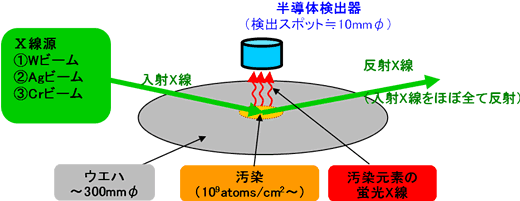
図1 装置概要
高感度、多元素分析の理由はトリプルビーム
3種類のX線源(トリプルビーム)により、Wビームでは高感度に測定できないナトリウム(Na)、モリブデン(Mo)等の元素も高感度に評価する事が出来ます。
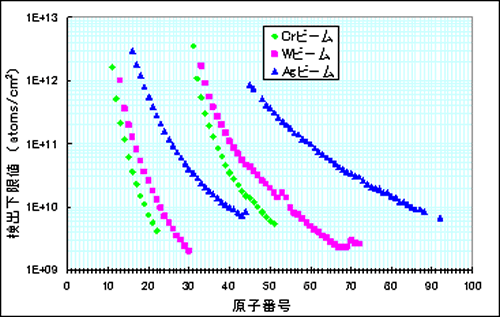
図2 全反射蛍光X線分析の検出下限値(シリコンウエハ)
異なるビームでも同じ元素を測定する事が出来ますが、感度や妨害ピークによる干渉を考慮し、最適なビームを選択する事が出来ます。
測定可能元素
Na~U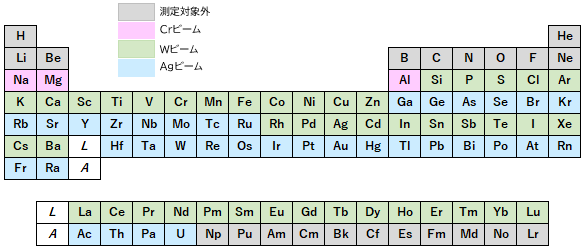
分析可能な元素についてはご相談ください。
3種類のX線源別の測定可能元素
| Crビーム | Na~Al |
|---|---|
| Wビーム | Si~Zn、Rh~Lu(特にK~Znに対して効果的です) |
| Agビーム | Ga~Ru、Hf~U(特にAs、Zr、Mo、Ta、W、Br、Pt、Auに対して効果的です) |
適用例
SiC基板表面の金属汚染評価事例TXRF、ICP-MSにて評価した次世代パワー半導体の基板表面の極微量金属汚染事例です。




 閉じる
閉じる