汚染分布からトータル汚染量評価まで、ニーズに合わせて最適手法をご提案いたします。
ウェハ全面、一部分、端部等、希望の測定範囲をご相談下さい。
ウェハ表面に存在する汚染はデバイス特性を劣化させ、デバイスの製造歩留まりに大きな影響を与えます。
これらの汚染は、ウエハの製造段階で既に存在するものや、デバイス製造プロセスで付着するものがあり、汚染チェックをすることは防汚管理において重要です。また、デバイスのデザインルールは年々厳しくなり、製造プロセスにおける清浄度の要求レベルも上がってきています。
お客様の目的に合わせて、次の4つの評価手法から最適な手法をご提案いたします。
全反射蛍光X線分析(TXRF)
全反射蛍光X線(Total Reflection X-ray Fluorescence)分析(以下、TXRFと表記)は、デバイス特性に影響する汚染元素を前処理無しで高感度(109atoms/cm2~)に分析することができます。

特徴
- 109atoms/cm2~ の高感度分析です。
- 多元素同時分析ができます。(同時分析可能な元素の組み合わせはお問合せ下さい)
- シリコンウエハ以外の異種基板や膜付基板等の対応ができます。(可能な基板の種類はお問合せ下さい)
- 非破壊・非接触分析 (X線照射)
→全反射蛍光X線分析(TXRF)について、より詳しい情報はこちら
全反射蛍光X線分析 全面高速マッピング (Sweeping-TXRF)
ウエハ全面を高速で分析し、詳細なマッピングデータから局所位置の汚染元素及び汚染量を分析することができます。
プロセス汚染のルーチンモニタリング、トラブルシューティング、製造装置/検査装置立上げの汚染チェックなどに最適です。
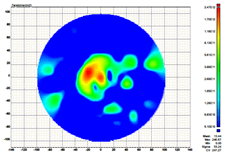
特徴
- 1010atoms/cm2オーダーの汚染から検出できます。
- 300 mmウエハまで対応できます。
- 測定点数は任意の選択ができますのでご相談下さい。
- Sweeping-TXRFの結果を元に、各測定点を従来のTXRFで高精度測定する事ができます。
→全反射蛍光X線分析 全面高速マッピング (Sweeping-TXRF) より詳しい情報はこちら
気相分解法(VPD)-誘導結合プラズマ質量分析(ICP-MS)
気相分解法(VPD)-誘導結合プラズマ質量分析(ICP-MS)(以下、VPD-ICP-MSと表記)によって、高精度の分析ができます。
シリコンウエハ表面全面、あるいは裏面全面に加え、任意の局所表面箇所やウエハエッジ部、ベベル部、ノッチ部を選択できます。
特徴
- シリコンウエハ表面の汚染分析ができます。
- 1×108atoms/cm2オーダーの汚染から検出できます(300mmウエハの場合)。
- 4インチ~12インチウエハまで対応できます。
- 測定箇所は任意の選択ができますのでご相談下さい。
→気相分解法(VPD)-誘導結合プラズマ質量分析(ICP-MS) について、より詳しい情報はこちら
イオン分析 基板表面に付着したイオン成分の評価
自動回収装置を用いることで、各種基板表面上の付着イオンを、これまで以上に高感度・高精度に分析することや、鏡面・裏面における任意箇所の分析も可能になりました。
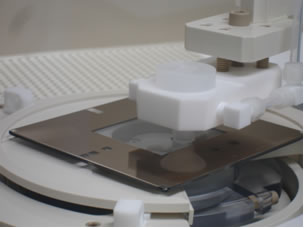
特徴
- 1010molecule/cm2オーダーの汚染から検出できます。
- シリコンウエハ以外にも、フォトマスク、石英ガラスなどの基板にも対応できます。(可能な基板の種類・サイズはお問い合わせ下さい)
- 測定箇所は任意に選択ができますのでご相談下さい。
→ イオン分析 基板表面に付着したイオン成分の評価について、より詳しい情報はこちら
精密洗浄ソリューション
- ダストサンプラー
- ペレット洗浄サービス
- クリーンパック
- クリーン化コンサルティング
精密洗浄ソリューションの詳細はこちらをご覧ください。


 閉じる
閉じる